明日の社長ブログで、弊社にとって大きなご報告を予定しています。
本日午後、経済産業省より正式発表される内容です。ぜひご期待ください!そのため、火曜日の技術コラムを本日と入れ替えて掲載しました。
技術コラムVol.14「スパッタ装置の基本構成」前回のコラム(Vol.13)では、スパッタとは何かという基本原理について解説しました。簡単に言えば、プラズマの力で材料原子を叩き出し、基板に薄膜を形成する技術でした。今回は、そのスパッタを実現するスパッタ装置の基本構成について見ていきます。一見シンプルに見える装置ですが、実際には多くの技術要素が組み合わさっています。
■ スパッタ装置の基本構造:一般的なスパッタ装置は、次のような主要構成で成り立っています。
・真空チャンバー
・ターゲット(成膜材料)
・マグネトロン(磁石)
・電源
・ガス導入系
・真空排気系
・基板ホルダー
これらが連携することで、安定した成膜プロセスが実現します。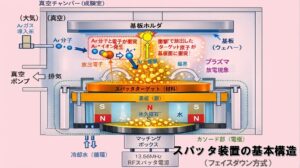
■ 真空チャンバー:スパッタは 真空環境 で行われます。真空チャンバーは
・外部から空気を遮断
・プラズマ生成空間の確保
・ガス流量の制御
といった役割を持っています。半導体装置では、このチャンバーの設計が装置性能を大きく左右します。
■ ターゲット(成膜材料):ターゲットとは膜として形成したい材料そのものです例えば
・アルミ・チタン・銅・モリブデン などの金属材料が使われます。
プラズマ中のアルゴンイオンがこのターゲットに衝突し、材料原子が飛び出します。
■ マグネトロン(磁場):現在のスパッタ装置の多くはマグネトロンスパッタ と呼ばれる方式です。ターゲットの裏側に磁石を配置し、磁場を作ります。この磁場によって
・電子が閉じ込められる
・プラズマ密度が高くなる
・スパッタ効率が向上する
という効果があります。
■ 電源(プラズマ生成):スパッタでは電源によってプラズマを発生させます。代表的な方式は
・DC電源(直流)・RF電源(高周波) です。材料や膜種によって電源方式が使い分けられます。
■ ガス導入系:スパッタではアルゴン(Ar)ガス を導入します。アルゴンは
・化学的に安定・イオン化しやすい という特徴があり、プラズマ生成に適しています。
また反応性スパッタでは ・窒素 ・酸素 などのガスも使われます。
■ 真空排気系:スパッタ装置では高真空環境を維持する必要があります。そのため
・ドライポンプ ・ターボ分子ポンプ などの真空ポンプが使用されます。
真空技術は半導体装置の重要な基盤技術です。
■ 基板ホルダー:基板ホルダーはウエハーを保持する装置部分です。ここでは
・温度制御 ・回転制御 ・バイアス電圧 などが制御され、膜品質に大きく影響します。
■ 装置設計のポイント:スパッタ装置の設計では、次のような点が重要になります。
・プラズマの安定性
・膜厚の均一性
・パーティクル対策
・熱管理
・メンテナンス性
これらを総合的に考える必要があります。ここに装置メーカーや設計会社のノウハウが詰まっています。
■ 次回予告:次回のコラムではVol.15「DCスパッタ」について解説します。半導体装置は巨大な機械に見えますが、その中ではナノレベルの世界が精密に制御されています。その中心にあるのが、今回紹介したスパッタ装置です。