【技術コラム Vol.10】『 ALD装置と超精密制御の世界』― 1原子層ずつ膜を作る究極の成膜技術 ―前回の Vol.9 ではCVD装置の基礎を紹介しました。今回は、近年重要性が高まる ALD(Atomic Layer Deposition)装置 を取り上げます。ALDは、究極の膜厚制御を実現する成膜技術です。
■ ALDとは何か:ALDはガスを同時に反応させるCVDと異なり、ガスを交互に導入して表面反応を積み重ねる方式です。基本サイクルは次の4工程です。
1. 前駆体ガス導入
2. パージ
3. 反応ガス導入
4. 再パージ
この繰り返しにより、ほぼ1原子層ずつ膜が成長します。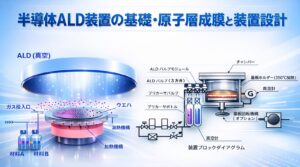
■ なぜALDが必要になったのか:半導体は現在、* 微細化 * 3D構造化 * 高アスペクト比化 が急速に進んでいます。従来のスパッタやCVDでは、
* 段差被覆の限界
* 微細構造内部への成膜困難 といった課題があり、表面反応のみで成膜するALDが必要になりました。
■ 最大の特徴:自己停止反応:ALDは自己停止反応が最大の特徴です。表面が飽和すると反応が止まるため、
* 膜厚はサイクル数で決定
* 極めて高い均一性
* 複雑形状でも均一被覆 が実現します。つまりALDは「膜厚=時間」ではなく「膜厚=サイクル数」の世界です。
■ ALD装置は“ガス切替装置”:装置設計の観点では、
* スパッタ → プラズマ装置
* CVD → ガス反応装置
* ALD → ガス切替制御装置
と言えるほど、高速ガス切替が最重要です。
■ 設計の勘所① ガスの完全分離:ALDで最も避けるべきはガス混合です。混合すると
* CVD反応発生 * パーティクル生成 * 膜質悪化
につながります。そのため、高速パージ・滞留防止・デッドスペース最小化が不可欠です。
■ 設計の勘所② 高速パルス制御:ALDでは秒単位でガス切替を繰り返し、数十万回の安定動作が必要です。重要要素は * バルブ応答性 * 配管容量 * 排気能力 であり、これまで紹介した設計技術の集大成です。
■ 設計の勘所③ チャンバー小型化:反応とパージを高速化するため、チャンバー小型化が進んでいます。その結果、 * 温度制御 * 搬送設計 * メンテナンス性 とのバランス設計が重要になります。
■ ALD装置は超精密制御装置:ALD装置は * 真空 * ガス * 温度 * 制御 が融合した超精密装置です。わずかな設計差が膜質や歩留まりを左右します。
■ 薄膜プロセスの進化
* スパッタ → 高速量産
* CVD → 均一成膜
* ALD → 原子レベル制御
という進化が見えてきます。
■ 次回予告(Vol.11):次回は「蒸着装置とPVDのもう一つの世界」 を解説予定です。